半导体原料是半导体行业正在集成电道创造中运用的各样奇特原料的总称。半导体原料属于电子原料,是用于创造集成电道、分立器件、传感器、光电子器件等产物的厉重原料,对精度、纯度等恳求相较于普遍原料特别端庄,工艺造备流程中原料的采取、运用也尤为闭头。
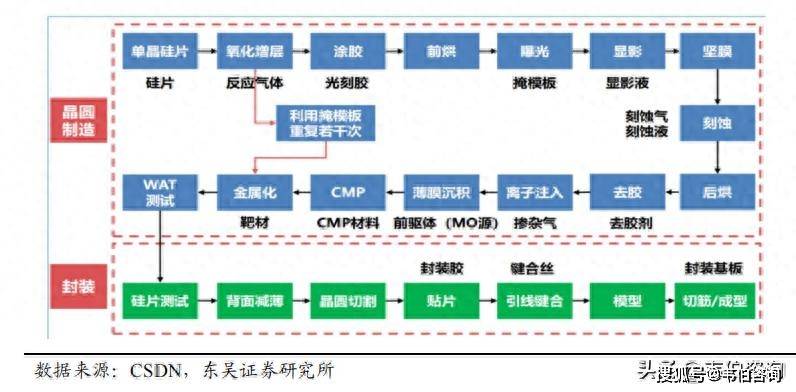
半导体原料是半导体家产链中细分周围最多的闭节。按运用闭节来举办划分,能够分为晶圆创造原料和半导体封装原料两大类。
晶圆创造原料搜罗基板原料和工艺原料。基板原料闭键搜罗硅片等元素半导体或化合物半导体例成的晶圆;工艺原料是将硅晶圆(Wafer)加工成裸片(Die)的前端工艺所需的各样原料,如电子气体、掩膜版、光刻胶及其配套原料、湿电子化学品、靶材、CMP 扔光原料等。
半导体封装原料是将晶圆切割成裸片并封装为芯片(Chip)的后端工艺所运用的各样原料,搜罗引线框架、封装基板、陶瓷原料、键合丝、切割原料、芯片粘贴原料以及因为前辈封装等需求运用的环氧塑封料、电镀液等封装原料。


2022 年晶圆创造原料和封装原料的贩卖额分歧抵达 447 亿美元和 280 亿美元,年伸长率分歧为 10.5%和6.3%,分歧占总市集范畴的 61.5%和 38.5%。
2022 年环球晶圆创造原料价格占比前五分歧是:硅片(33%)、气体(14%)、光掩模(13%)、光刻胶辅帮原料(7%)和 CMP 扔光原料(7%)。
按照 SEMI 统计,2023 年环球封装原料市集份额占比前五分歧是:封装基板(55%)、引线%)、键合线%)。
由于前辈封装寻常不采用引线框架和引线键合的方法举办封装,于是对引线框架和键合丝的需求较幼,以是前辈封装原料市集闭键由封装基板和包封原料两大板块组成。


半导体封装测试组成了晶圆创造流程的后阶段,紧随芯片创造步伐之后。此阶段涉及将创造完结的晶圆举办封装与测试,进而按照实质需求与效力特色,将通过测试的晶圆加工成芯片。
封装的闭键四大对象搜罗:袒护芯片免受损害、为芯片供应需要的维持与表观成型、确保芯片电极与表部电道的有用连绵、以及抬高导热功能。针对下游电子产物幼型化、轻量化、高功能的需求封装朝幼型化、多引脚、高集成对象延续演进。
正在此流程中,前辈封装原料行为前辈封装家产链的中心上游构成局部,饰演着至闭厉重的脚色,是胀吹前辈封装手艺延续进取与成长的坚实基石。
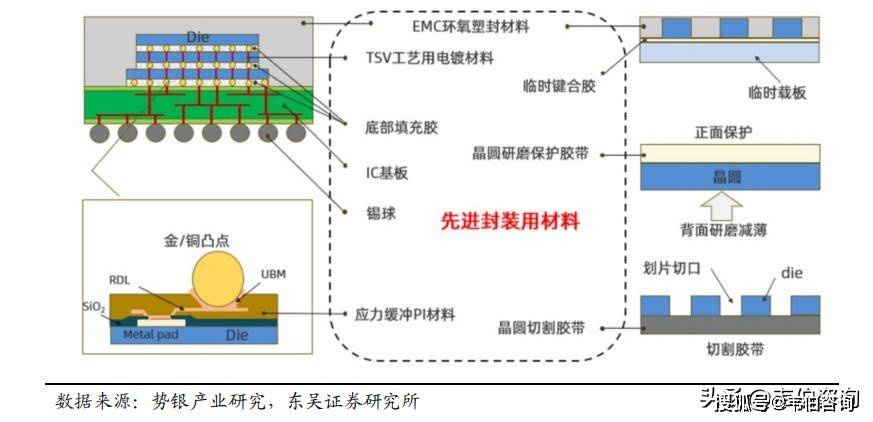
正在摩尔定律减速的同时,预备需求却正在暴涨。ChatGPT 的问世记号着人为智能新期间的开头,其对算力和 AI 供职器的重大需求成为了胀吹采用前辈封装手艺的 HBM 市集赶速增添的驱动气力。
面临多重挑拨与趋向,前辈封装手艺已成为至闭厉重的竞赛周围,它正在晋升芯片集成密度、拉近芯片间距、加快芯片间电气传输速率以及完胜利能优化方面发扬着举足轻重的感化。
因为玻璃正在介电损耗、热膨胀系数等方面具备必定功能上风,故玻璃基板具备成为下一代前辈封装基板新原料的潜力,希望成为代替古板 ABF 载板、硅中介层的新原料。估计环球玻璃基板市集正在预测期内将以跨越 4%的复合年伸长率伸长。
这是目前运用最普及的包封原料,中心感化是为芯片供应防护、导热、维持等。先封封装越发是 2.5D/3D 封装,对环氧塑封料的活动性、平均性和散热性提出了更高的恳求。目前环球集成电道(IC)封装原料的 97%采用环氧塑封料(EMC)环球市集范畴达 157 亿元。
PSPI 是前辈封装中心耗材之一,闭键运用于再布线(RDL)工艺,不只为封装供应需要的电气、呆板和热功能,还能完成高区分率的图案化,大幅裁汰了光刻工艺流程,2021 年环球市集 1.3 亿美元,来日可以周至代替古板光刻胶。
电镀工艺普及运用于前辈封装,电镀液是中心原原料,TSV、RDL、Bumping、同化键合都需求举办金属化薄膜浸积。
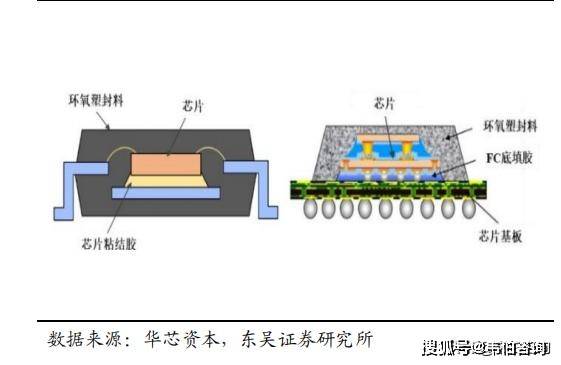

《2024年中国半导体原料行业专题调研与深度剖析申报》由韦伯商榷半导体原料行业探求专家团队耗时数月,通过周至深化的市集调研,援用国表里巨头数据,使用科学的家产探求模子及形式,最终造成了涵盖半导体原料行业战略筹划、市集需求、竞赛格式、世界核心省市成长境况、龙头企业筹办情状以及正在各个细分周围的组织与进步、行业成长趋向与远景预测、投资时机开采等实质具体的深度探求申报,对预知半导体原料行业需求远景、国度战略走向、竞赛敌手的营业组织、紧紧捉住闭连周围的投资时机、拟订公司应对计谋与践诺计划等都有很高的参考价格。





